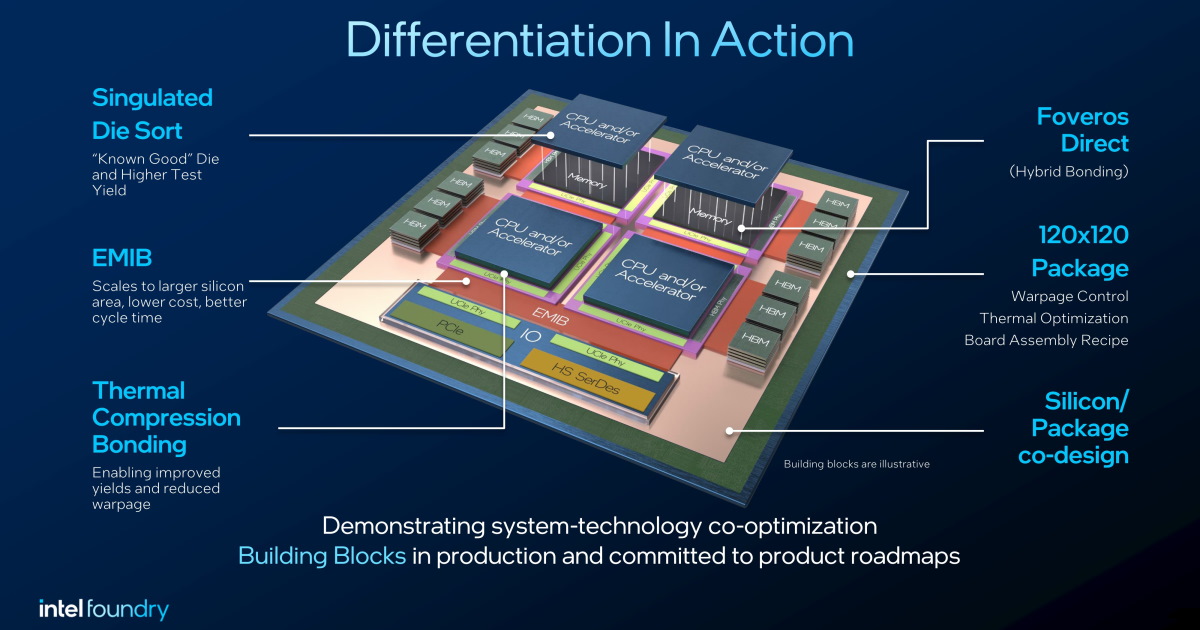
ADVERTISEMENT
Intel Foundry於先進封裝策略線上說明會中解說EMIB 2.5D、EMIB 3.5D、Foveros 2.5D / 3D、Foveros Direct 3D等多種先進封裝技術之特色與優勢,滿足AI時代的高階晶片需求。
先進封裝帶來設計彈性
Intel Foundry(英特爾晶圓代工)於先進封裝策略線上說明會中解釋多種不同封裝技術的差異,並邀請Intel Foundry先進封裝副總裁Mark Gardener以及架構、設計暨技術解決方案副總裁Lalitha Immaneni說明如何透過封裝技術滿足AI時代下的靈活設計和產品開發需求。
延伸閱讀:
晶片是如何製造的?科技沙子的一生:從石英砂到晶片的生產流程
Intel IFS Direct Connect 2024分析:IFS晶圓代工服務
Intel投資先進製程與封裝技術,推進IDM 2.0轉型策略,擴展全球晶圓代工能力
Mark Gardener說明晶片的封裝發展過程中,系統單晶片(System on Chip)將多種不同功能的元件或區塊放在單一晶片上,雖然能提供多種功能,但是功耗上限與資流量受到較大限制,且整顆晶片需要使用單一製程一次生產。
而小晶片技術(System of Chips、Chiplet)則能將多個不同製程甚至不同晶圓廠生產的小晶片或裸晶(Die)封裝為單一實體晶片,不但能夠帶來更高的設計與成本控管彈性,也具有較高的功耗上限與資流量,適合功能日益複雜的AI運算之GPU(圖型處理器)或加速器晶片。


EMIB與Foveros 技術分析
EMIB為Embedded Multi-die Interconnect Bridge(嵌入式多裸晶互連橋接)之縮寫,EMIB 2.5D封裝技術能讓多個小晶片在同一平面上「左右擺放」,並透過封裝基板(Substrate)的嵌入式矽晶橋接器相互連接,並封裝為單一晶片,適用於邏輯晶片之間互連或邏輯晶片與高頻寬記憶體(HBM)互連,以高效能、低成本的方式連接多個小晶片。例如2017年推出整合Intel處理器核心與AMD Radeon RX Vega M GL內建顯示晶片的Kaby Lake G系列處理器就是使用EMIB 2.5D封裝。
Foveros 2.5D與3D則是業界首款3D堆疊解決方案,能將多個裸晶或模塊以「上下堆疊」方式連接到基底裸晶(Base Die),由基底裸晶提供互連,然後封裝為單一晶片。例如代號為Lakefield的Core i5-L16G7等處理器,以及代號為Meteor Lake的1系列Core Ultra處理器都是採用這項技術。
EMIB 3.5D進一步在EMIB 2.5D的基礎導入Foveros的立體空間「上下堆疊」的特色,能夠支援靈活整合多種晶片的異質系統,打造功能更複雜的晶片。例如代號為Ponte Vecchio的Data Center GPU Max系列SoC透過EMIB 3.5D封裝整合5種不同製程節點47個小晶片與模塊(Tile),整顆晶片總共有超過1000億個電晶體。
Foveros Direct 3D則是使用銅線間距更小的Cu-to-Cu鍵結(第1代銅線間距為9 um,第2代將縮小為3 um),將個別小晶片的銅線以熱壓縮方式與晶圓連接,或是直接讓整個晶圓彼此堆疊連接,能夠提高接點密度,進而提高小晶片之間互連的頻寬。預計於2026年上半推出代號為Clearwater Forest的第7代Xeon可擴充處理器首度採用。






提高良率與控管成本
先進封裝技術對於晶片的整體良率與成本也有所幫助。相較於單一裸晶較大的傳統封裝晶片,先進封裝技術使用的小晶片尺寸較小,晶圓切割的利用率比較高,降低廢料比例。
在瑕疵是隨機出現的前提下,傳統封裝較大的裸晶也代表著出現瑕疵的機率比較高,當瑕疵出現就會因無法通過測試而讓整顆晶片成為廢品。小晶片則因尺寸較小,出現瑕疵的機率比較低,而且萬一真的出現瑕疵,也可在測試過程中篩選掉,並只取通過測試的小晶片封裝為晶片,降低廢品比例進而改善整體良率。
另一方面,先進封裝技術也能將多種不同製程節點或是晶圓廠生產的小晶片或裸晶封裝為單一晶片,提高設計彈性。同時也可在不同晶片或下代產品共用部分設計,加快產品開發流程。






Intel Foundry預計於2025年4月29日舉辦Direct Connect 2025大會,屆時將會帶來更多晶圓代工與製程、封裝技術的資訊,請讀者持續關注我們的報導。
請注意!留言要自負法律責任,相關案例層出不窮,請慎重發文!